Der Artikel erschien 1998 in den DPMA-Erfinderaktivitäten
Rasterkraftmikroskopie
Dipl.-Phys. Karsten Franke
Der Beitrag befasst sich mit den Prinzipien der Rasterkraftmikroskopie und hierauf aufbauenden Technologien zur Untersuchung und Bearbeitung von Oberflächen aller Art im Nanometerbereich und stellt einige neuere, beim DPMA angemeldete Lösungen hierzu vor.
G. Binnig und G. Rohrer entwickelten am IBM-Forschungslabor in Zürich 1981/1982 das sog. Raster-Tunnelmikroskop (STM "Scanning Tunneling Microscope"), wofür sie 1986 gemeinsam den Nobelpreis für Physik erhielten. Das STM stellt die Grundlage aller weiteren Geräte dar, die heute in großer Zahl vorliegen und der Abbildung oder Manipulation von Oberflächen aller Art dienen. Die Untersuchung erfolgt in der Regel zerstörungsfrei und hochauflösend hinsichtlich der Topographie von Proben bzw. selektiv bzgl. deren verschiedenster physikalischer Eigenschaften.
Anders als z.B. die Elektronenmikroskopie, die zur Untersuchung und Abbildung von Strukturen im atomaren Bereich aufwendige Probenpräparationstechniken und hohe Vakua voraussetzt sowie regelmäßig zur Schädigung der Proben führt, kann mit dem STM und anderen Rastermikroskop-Varianten insbesondere auch unter Atmosphärenbedingungen gearbeitet werden.
Beim STM wird im Abstand von nur wenigen Nanometern eine äußerst fein zulaufende Metallspitze mit Hilfe von Piezo-Aktuatoren zeilenweise über die zu untersuchende Oberfläche geführt, die hierzu elektrisch leitend sein muss. Eine zwischen Spitze und Oberfläche angelegte geringe Spannung führt zu einem abstandsabhängigen Tunnelstrom, der durch eine Rückkopplungselektronik erfasst wird. Deren Signal steuert einen weiteren Piezoaktuator, der der Variation des z-Abstandes zwischen Spitze und Oberfläche dient. Wird der Tunnelstrom so geregelt, dass er und mit ihm der Abstand konstant bleibt, zeichnet die Spitze die Topographie der Oberfläche nach. Verknüpft mit der Information über die jeweilige Flächenkoordinate der die Probe abrasternden Spitze kann ein dreimensionales und auf bis zu Bruchteilen von Nanometern aufgelöstes Bild der untersuchten Oberfläche (horizontal 0,1 nm, vertikal bis zu 0,01 nm) gewonnen und mittels Bildschirm dargestellt werden.
War diese Basis-Methode noch auf die Untersuchung leitfähiger Proben beschränkt, so gestattete die spätere Entwicklung des sog. Atomkraftmikroskops (AFM "Atomic Force Microscope" bzw. SFM "Scanning Force Microscope" - 1985 zunächst durch G. Binnig und C. F. Quate) und seiner Nachfolger auch die Untersuchung isolierender und halbleitender Proben. Hier tastet ebenfalls eine scharfe, idealerweise mit einem einzigen Atom endende Spitze eine Probenoberfläche in geringstem Abstand, dem sog. Nahfeldbereich, ab. Zwischen der meist auf einem federnden Hebelarm (Cantilever) angeordneten Spitze und den jeweils nächstgelegenen Atomen der Probenoberfläche wirken zwischenatomare Kräfte. Es kann in einem die Probe stets oder intermittierend kontaktierenden oder im nicht kontaktierenden Modus gearbeitet werden.
Im Fall des Kontaktmodus wirken Abstoßungskräfte mit extrem kurzen Reichweiten aufgrund der Überlappung der Elektronenwolken der Atome. Die Konstanthaltung dieser lokal sehr starken Kräfte und damit des Probe-Spitze-Abstandes - als Basis für die Gewinnung eines Höhenprofils der Probenoberfläche analog zu den Verhältnissen beim STM - setzt die Erfassung der z-Bewegung der Spitze voraus. Dies gelang zunächst durch ein nachgeschaltetes STM, bei der der Rückseite des leitfähigen Cantilevers die Rolle der Probenoberfläche bei konventionellen STM-Untersuchungen zukam (vgl. Fig. 1 - nach Bai, Ch., Scanning Tunneling Microscopy and its Application, Springer Series in Surface Sciences 32, Springer-V. 1992). Später wurde die Auslenkung des Cantilevers direkt, z.B. mittels Laser (Fig. 2 - nach DE 19504855 A1) bzw. interferometrisch oder kapazitiv bestimmt. Heute erfolgt die Erfassung der Auslenkung oft durch direkt am Cantilever bzw. - im Nicht-Kontakt-Modus - am Schwinger angeordnete, auf Verbiegungen desselben ansprechende piezoelektrische Elemente (vgl. Fig. 6 und 7). Die Untersuchung im Kontaktmodus kann jedoch zur Beschädigung der Probenöberfläche und Abnutzung der Mikroskopspitze und damit insbesondere zu einer verminderten Auflösung führen.
Im naturgemäß völlig zerstörungsfreien Nicht-Kontakt-Modus wird die Spitze eines modifizierten AFM der Probe lediglich stark angenähert, was z.B. die Möglichkeit eröffnet, auch weiche Materialien, z.B. biologische Proben zu untersuchen. Hierbei oszilliert die Mikroskopspitze - angeregt durch einen piezoelektrischen Wandler - nahe ihrer Resonanzfrequenz. Bei Annäherung der vibrierenden Spitze an die Probenoberfläche wirken schwache Anziehungskräfte mit sehr geringer Reichweite zwischen Spitze und Probe - sog. van-der-Waals-Kräfte. Deren Wirkung wird ggf. durch die Oberflächenspannung von Gas- und Flüssigkeitsadsorbaten (z.B. Kohlenwasserstoffmoleküle, Wasserdampf oder kondensiertes Wasser aus der Umgebungsluft) auf der Probenoberfläche verstärkt. Die Anziehungskräfte äußern sich in einer Verringerung der Resonanzfrequenz und mit ihr der Amplitude der Schwingung der Mikroskopspitze, die z.B. laserinterferometrisch bestimmt werden kann. Wird die Schwingungsamplitude über eine Rückkopplungselektronik konstant gehalten, was einer Abstands- und Kraftkonstanz entspricht, kann analog zu den vorgenannten Mikroskop-Varianten ein Höhenprofil der Probe aufgenommen werden. Die Ortsauflösung im Nicht-Kontakt-Modus ist jedoch vor allem beim Einsatz unter Atmosphärenbedingungen durch den die Topographie-Information verfälschenden Einfluss der Adsorbatschichten auf die Schwingungsdämpfung der Mikroskopspitze meist sehr begrenzt.
Praktische Bedeutung hat vor allem der intermittierende Betriebsmodus des AFM erlangt, bei dem die Mikroskopspitze mit einer größeren Amplitude als im Nicht-Kontakt-Modus vibriert. In der Nähe der Probenoberfläche wird die Oszillation infolge der dort wirkenden Kräfte gedämpft, die Amplitude wird verkleinert und die Spitze berührt die Probenoberfläche pro Messpunkt vielmals leicht (sog. Tapping Modus). Dies erfolgt mit einem gegenüber dem Kontaktmodus wesentlich verringerten Energieumsatz, so dass auch gegen Beschädigungen anfällige Proben, wie biologische Materialien oder Halbleiterwafer, untersucht werden können. Die dämpfungsbedingt erniedrigte Schwingungsamplitude wird durch eine Rückkopplungselektronik konstant gehalten, so dass die mittlere z-Koordinate der Spitze der Probentopographie folgt.
Durch spezielle Ausgestaltung der verwendeten Mikroskopspitzen und des Verfahrensablaufs können im Nicht-Kontakt- bzw. im Tapping-Modus des AFM z.B. magnetische und elektrische Eigenschaften von Probenoberflächen ermittelt werden. Mit magnetisierten Mikroskopspitzen eines MFM (Magnetic Force Microscope) ist beispielsweise die Speicherdichte bzw. -qualität magnetischer Speichermedien bestimmbar. Elektrische Eigenschaften von Oberflächen, z.B. die Dotandenkonzentration und -Verteilung in Wafern, wie sie bei der Mikrochipherstellung kritische Parameter darstellen, können mittels EFM (Electrostatic Force Microscope) ermittelt werden. In einem einzigen Scan-Vorgang der Probenoberfläche -vzw. im Tapping-Modus - werden dabei in zwei separaten Durchgängen pro Messpunkt einerseits die atomaren Wechselwirkungen zwischen Probe und oszillierender Spitze (vzw. im Tapping-Modus) zur Aufnahme der Probentopographie und andererseits die magnetischen bzw. elektrostatischen Wechselwirkungen bestimmt. Letzteres erfolgt unter Berücksichtigung des unmittelbar zuvor ermittelten Einflusses der Probentopographie bei vergrößertem Probe-Spitzenabstand (Lift-Modus) - mithin unter vernachlässigbarem Einfluss atomarer Kräfte, die eine wesentlich kürzere Reichweite als magnetische und elektrische Kräfte besitzen.
Neben mehreren weiteren Varianten des AFM soll hier noch das Nahfeld-Scanning-Mikroskop (NSOM "Nearfield Scanning Optical Microscope") erwähnt werden, das in Kombination mit AFM's oder dessen Spielarten verwendet werden kann, indem z.B. eine optische Faser als AFM-Spitze dient. Bei dieser Art von NSOM wird eine Probe punktweise gerastert von Laserlicht be- bzw. durchstrahlt. Das hierzu benutzte Licht wird meist mittels eines Lichtwellenleiters an die Probe herangeführt, der an seinem Ende eine opake Schicht trägt, die eine Apertur im Subnanometerbereich aufweist (s. Fig. 3 - nach aaO. Bai). Ein Detektor registriert ortsabhängig das mit der Probe wechselwirkende Licht - z.B. im Transmissions-, Reflexions- oder Fluoreszenz-Modus - so dass die Aufnahme eines Rasterbildes der unmittelbar vor der Apertur angeordneten Probe ohne Begrenzung der Auflösung durch Beugung möglich ist.
Oberflächenmodifikation
Die Eignung von Geräten der hier vorgestellten Art zur hochauflösenden Abbildung von Oberflächen bis hin zur Darstellung von Gegenständen in der Größenordnung von Atomdurchmessern legt auch ihre Verwendung zur gezielten chemischen oder physikalischen Oberflächenmodifikation im Nanometerbereich nahe. So gestattet das STM z.B. kontrollierte Manipulationen von Metalloberflächen durch direkte mechanische Einwirkung der Mikroskopspitze. Bei Stromzuführung zum Tunnelübergang sind die Herauslösung von Atomen aus Kristallverbänden und deren Transport zu anderen Stellen der Probenoberfläche, die Abscheidung von Material der Spitze selbst auf der Probe oder materialabtragende Ätzvorgänge ebenso möglich, wie verschiedene chemische Oberflächenreaktionen sowie die Abscheidung von Metallen (z.B. als Leiterbahnen) aus gasförmigen Verbindungen. Darüber hinaus ist die lokale Exposition vzw. ultradünner Elektronen-Resist-Schichten analog zu elektronenstrahllithografischen Prozessen möglich, wozu das Gerät ggf. im Feldemissions-Modus betrieben wird. Die Anwendungsgebiete von Manipulationen im Nanobereich sind beispielsweise die Reparatur von integrierten Schaltkreisen oder die von Masken für die herkömmliche Elektronenstrahllithographie.
Für Oberflächenmodifikationen an halbleitenden oder elektrisch isolierenden Materialien steht das AFM zur Verfügung, das hierzu in der Regel im Kontakt-Modus arbeitet. So können z.B. weiche Materialien, etwa dünnste Resist-Schichten für lithographische Prozesse, lokal mechanisch geritzt bzw. entfernt werden. Mittels Silizium-Cantilevers mit integriertem Widerstandsheizer und piezoresistivem Sensor gelingt ferner die Erhitzung von AFM-Spitzen auf Temperaturen bis zu 170°C, so dass durch lokale Schmelzvorgänge Strukturen, z.B. in Kunststoffe, wie PMMA (Polymethylmethacetat) thermomechanisch eingebracht werden und zur Speicherung und Auslesung digitaler Informationen genutzt werden können (vgl. Fig. 4 - nach Chui, B. W., J. Microelectromech. Syst. 7, 1998,69. Auf diese Weise sind von IBM Speicherdichten von 1010 Bits/cm2 - d.h. etwa dem 25-fachen der Speicherkapazität moderner Festplatten - erzielt worden.
Ein weiterer zukunftsorientierter Anwendungsbereich der Nanomodifikation von Objekten unter Verwendung des AFM ist der Einsatz an biologischen Materialien, etwa DNA-Molekülen, die simultan visualisier- und manipulierbar sind; so können die Stränge an vorbestimmten Stellen hochgenau getrennt werden, um dadurch z.B. fehlerhafte Gensequenzen herauszuschneiden, die später durch modifizierte DNA-Stücke zu substituieren sind.
Neuere DE-Anmeldungen zu AFM
In jüngerer Zeit beim DPMA angemeldete technische Lösungen betreffen u.a. die Gestaltung der die Oszillation der Mikroskopspitze regelnden Einheiten sowie die Auswertung der Änderung der Oszillation aufgrund des Einflusses der o.g. Kräfte. So wird mit DE 19510368A1 (vgl. Fig. 5) vorgeschlagen, als Schwinger eine gekoppelte Oszillatoranordnung, insbesondere eine Stimmgabel zu verwenden (vgl. hierzu allerdings Dransfeld, K. u.a. EP 0 372 060 A1), die eine als AFM- und NSOM-Sonde nutzbare optische Faser trägt. Der Schwinger weist auf seiner Oberfläche piezoelektrische Materialien z.B. in Schichtform auf, mittels derer zugleich die Schwingung angeregt und aufrechterhalten (Aktuatorschichten) als auch die Änderung der Oszillation erfasst werden kann (Detektorschichten).
Zur Kombination der Betriebsarten des AFM, STM und NSOM in einem Gerät wurden Lösungen, darunter diejenige nach DE 19531466A1 vorgeschlagen, die eine mehrschichtige Auslegeranordnung - bestehend aus einer Schicht piezoelektrischen Materials zur Abtastung bzw. Anregung des Schwingers zur Wahrnehmung der AFM-Funktion (kontaktierender und nichtkontaktierender Modus) sowie mehreren Metallschichten und einer Lichtwellenleiterschicht zur Sicherung der STM- bzw. NSOM-Funktion - betrifft, die an ihrem Ende eine optisch transparente Abtastspitze trägt (vgl. Fig. 6). Anmeldungen verwandten Inhalts zur Kombination mehrerer Betriebsarten in einem Gerät sind in DE 19513529A1 (AFM/STM) und DE 19713746A1 (AFM/NSOM) niedergelegt.
Zur Erhöhung der Auslese- und Schreibgeschwindigkeit von Datenspeichern, die nach dem o.g. thermomechanischen Prinzip arbeiten, sind Arrays von AFM-Spitzen tragenden Cantilevern geschaffen worden, mittels derer eine Vielzahl von Bits simultan geschrieben oder ausgelesen werden können. DE 19701701A1 betrifft ein solches Array, bei dem die Einzelsonden zur Erzielung einer hohen Sondendichte V-förmig zueinander verschachtelt angeordnet sind (vgl. Bild 7).
Nach DE 19700747A1 ist eine aus Sondengrundkörper, piezoelektrischem Resonator und einer Sondenspitze bestehende rasterkraftmikroskopische Sonde zur Untersuchung in Flüssigkeiten in einer zum Messobjekt hin offenen, gasgefüllten Kapillare angeordnet, aus der die Sondenspitze herausragt. Der Gasdruck in der Kapillare wird so gehalten, dass die Flüssigkeit kaum oder gar nicht in die Kapillare eindringen kann und somit das Schwingungsverhalten des Cantilevers nicht verfälscht wird (Bild 8).
Ein Verfahren zur Feststellung von bestimmten, makroskopisch mit Wirkstoffeigenschaften verbundenen Wechselwirkungen, die u.a. zwischen verschiedenen molekularen bzw. biologischen Spezies aufgrund von Bindungskräften auftreten, ist nach DE 19631326A1 unter Einsatz eines Rasterkraftmikroskops möglich. Hiernach wird eine definierte Kleinstmenge einer zu testenden (Wirkstoff-)Spezies an die AFM-Spitze gebunden, während Material einer ggf. auf die erste Substanz ansprechenden zweiten (Rezeptor-) Substanz z.B. an (hierbei quasi als Objektträger fungierende) Makromoleküle gebunden wird. Die zwischen den Substanzen wirkenden Kräfte werden mittels des Rasterkraftmikroskops reproduzierbar gemessen und hieraus auf Wirkstoffeigenschaften des untersuchten Systems geschlossen. Ein effektives Wirkstoff-Screening einer großen Menge von als bestimmte Wirkstoffe in Betracht kommenden Substanzkonstellationen wird möglich (Fig. 9).
Eine weitere Lösung betrifft ein Verfahren zur Herstellung einer aus einem Elektronenstrahl-Resist (vzw. Polymetamethylacetat) bestehenden Maske auf einem Halbleitersubstrat, die durch die Einwirkung eines Fluides (vzw. ein Gemisch aus Methylisobutylketon und Isopropanol) unter dem Einfluss der zwischen der bewegten Sondenspitze eines Rasterkraftmikroskopes und der Maskenoberfläche wirkenden Kraft teilweise entfernt wird (DE 19531068A1).
Quellverzeichnis:
- 1. Bai, Ch., Scanning Tunneling Microscopy and ist Application, Springer Series in Surface Sciences 32, Springer-V. 1992
- 2. Chui, B. W., J. Microelectromech. Syst. 7, 1998,69

![]()
Fig. 1: ursprüngliches AFM
(nach: Bai, Ch., 1992)

![]()
Fig. 2: Kraftmikroskop mit Erfassung der Auslenkung des Cantilevers durch Laserstrahl
(nach Offenlegungsschrift DE 19504855A1)
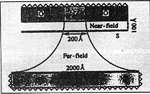
![]()
Fig. 3: Prinzip des NSOM
(nach: Bai, Ch., 1992)

![]()
Fig. 4: Prinzip der thermomechanischen Datenspeicherung mittels AFM, in dessen Cantilever eine Heizeinrichtung zum Schreiben und ein piezoresistiver Sensor zum Auslesen der Informationen integriert sind.
(nach Chui, B. W., 1998)

![]()
Fig. 5: Schwingeranordnung mit aufgeklebter Lichtwellenleiterfaser für kombinierte AFM / NSOM mit aufgebrachtem piezoelektrischem Material mit Sensor- und Aktuator-Funktion
(nach Offenlegungsschrift DE 19510368A1)

![]()
Fig. 6: mehrschichtige Auslegeranodnung für AFM/STM/NSOM-Kombination
(nach Offenlegungsschrift DE 19531466A1)

![]()
Fig. 7: verschachtelte Anordnung eines Arrays von AFM-Sonden
(nach Offenlegungsschrift DE 19701701A1)

![]()
Fig. 8:
(nach Offenlegungsschrift DE 19700747A1)

![]()
Fig. 9: Wirkstoff-Screening mittels AFM
(nach Offenlegungsschrift DE 19531326A1)
Copyright © Deutsches Patent- und Markenamt 2008
